2022年11月11-13日,第十九届“中国光谷”国际光电子博览会暨论坛(以下简称“武汉光博会”)将于中国光谷科技会展中心举办。同期还将举办“2022先进光刻技术研讨会”,届时将邀请业内知名专家,共同探讨光刻技术的前沿进展及未来发展趋势。
会议主题:2022先进光刻技术研讨会
会议时间:2022年11月12日9:30-16:45
会议地点:中国光谷科技会展中心三楼
►►►
组织机构
主办单位:国家工信部、国家科技部、国家知识产权局、中国科学院、中国国际贸促会、湖北省人民政府
承办单位:武汉市人民政府、武汉东湖新技术开发区管委会
执行承办单位:中国激光杂志社、上海意桐光电科技有限公司
►►►
大会主席

王向朝
中国科学院上海光学精密机械研究所研究员

韦亚一
中国科学院微电子研究所研究员
►►►
部分邀请嘉宾

师江柳
北京超弦存储器研究院首席光刻科学家
报告题目及摘要
题目:先进DRAM光刻工艺研发介绍
摘要:DRAM存储芯片市场份额巨大,发展前景广阔,是半导体产业的核心支柱之一。中国的DRAM市场接近全球的60%,但自给能力严重不足,亟需关键技术的突破。当前,北京超弦存储器研究院积极搭平台、引人才、建队伍、出成果,为国产存储器产业发展提供技术来源、协调资源调配、培养专业人才、实施知识产权保护,致力于成为国内存储器技术发展的“探路人”。本报告介绍先进DRAM光刻工艺研发的理论和方法。

施伟杰
东方晶源微电子科技(北京)有限公司常务副总经理
报告题目及摘要
题目:Practice on HPO:A Timing emphasis OPC Approach for OCV improvement
摘要:The Fabless/Fab mode has been proven successfully for IC manufacturing for decades. Fabs focused on patterning and yield while fabless concentrated on electrical performance, known as PPA. As the feature sizes continuously shrink, the design capability gap between available and realized manufacturing scaling grows larger, which eventually affects cost and time-to-market. To bridge this gap, a systematic solution namely, HPO (Holistic Processes Optimization) ,has been proposed by DFJY, which involves process variation aware physical design flow, timing and power aware OPC for electrical process window improvements and wafer defect inspection guided by timing critical paths and process-sensitive hotspots. In this talk, a timing emphasis OPC approach is practiced for OCV improvement under the HPO conception. Experiments have been performed to demo pros and cons.

王晓伟
苏州理硕科技有限公司总经理
报告题目及摘要
题目:延续摩尔定律下的光刻技术探讨
摘要:根据经典摩尔定律,集成电路晶体管数目大约每两年会增加一倍,性能也随之提高一倍,且价格下降一半。近年来,随着光刻技术的快速发展,光刻胶的线宽已经接近材料的极限分子尺寸,摩尔定律能否继续延续成为半导体行业一个不得不面对的问题。
13.5纳米EUV极紫外光刻机的出现,为摩尔定律的延续提供了一种可能。然而由于EUV光源强度过低、反射镜片的反射率衰减及光罩缺陷难题等设备问题,以及光刻胶解像度问题、outgas问题等各种技术难题有待克服,EUV光刻机量产化时间被多次推迟。作为EUV光刻的替代技术,如double patterning技术、纳米压印技术、DSA技术、多电子束直写技术等也被各大国际半导体组织和集成电路芯片企业深入研讨,随着近期各芯片厂家在技术上的突破,这些EUV替代技术开始逐步趋于成熟和实用。
由于光刻胶材料分子尺寸的限制和EUV光刻机的自身缺陷,EUV光刻机的解像性能依然差强人意,对于14纳米以下小线宽来说依然很难实现一次曝光成形。为此EUV+double patterning 和EUV+DSA技术作为超摩尔时代光刻技术的不得已选择,成为实现7纳米芯片技术的主要手段。
伴随着FinFET技术的出现,通过先进封装进行实现晶体管的多层叠加也是实现芯片高级程度的一个可行性方向,在不需要缩小图形线宽和提高光刻胶解像度的前提下,也能够大幅提高晶体管的集成度。但对于拉开芯片巨头和跟随厂家之间技术代差并无明显帮助,各大芯片巨头依然对EUV技术充满期待。

李小平
华中科技大学研究员
报告题目及摘要
题目:投影光刻机中的温度控制技术
摘要:投影光刻机的性能易受到温度波动的影响,超稳定温度控制技术是投影光刻机的关键技术之一。报告从投影光刻机温度控制、投影物镜的温度控制、浸没液体的温度控制、微空气环境温度控制四个方面介绍投影光刻机中的固体、水和空气的温度控制中的传热结构、控制模型和控制算法。
►►►
联系方式
会议咨询:
杜虹 17771025207(微信同号)
会议赞助:
吴雅慧 18672307517(微信同号)本届会议汇聚了光刻领域的一流科研机构与企业,是展示企业以及产品性能的最佳时机,欢迎各大厂商前来赞助~更多会议信息持续更新中,大家可关注本公众号的后续报道。报名链接:
http://suo.nz/1TLXBc
也可扫描下方二维码报名

转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读






















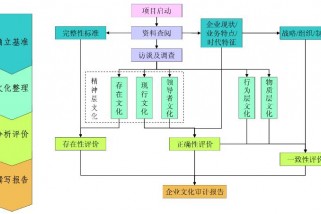












 关注我们
关注我们




