应用材料公司于3月推出Applied DFinder检测系统,用于在22纳米及更小技术节点的存储和逻辑芯片上检测极具挑战性的互连层。作为一项突破性的技术,该系统是首款采用深紫外(DUV)激光技术的暗场检测工具,使芯片制造商具有前所未有的能力,在生产环境中检测出图形化晶圆上极小的颗粒缺陷,从而提高产品良率。DFinder系统专门针对互连层的检测而设计,因此总拥有成本比其它暗场检测系统最多可降低40%。这对芯片制造而言是一项非常关键的优势,因为在这个过程中可能会涉及50多个独立的检测步骤。
DFinder系统采用独一无二的DUV激光照明技术,可检测出22纳米技术节点上小至40纳米的所有应该被关注的颗粒缺陷,这比其它任何暗场检测系统所能识别的颗粒小30%以上。此外,该系统专有的掠射角光路和全偏振控制,可有效地将颗粒缺陷从晶圆图形上分离出来,从而既能找出所有影响良率的颗粒缺陷,又能将“错报”和滋扰缺陷误报降低一个数量级。这种区分晶圆图形和重要缺陷的卓越性能,让客户几乎可以避免使用那些既耗时又昂贵的非图形化测试晶圆。
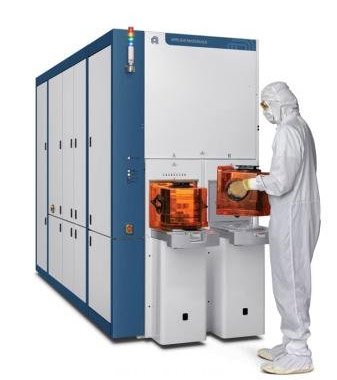
应用材料公司副总裁、工艺诊断和控制事业部总经理Ronen Benzion表示:“应用材料公司在薄膜沉积技术方面拥有的广博知识和丰富经验,使我们的检测技术具有独到之处,能够满足客户提高下一代芯片良率的要求。这种能力是任何其他设备供应商都无法提供的。我们这套DFinder系统从头打造专门针对新一代缺陷。我们的晶圆代工和存储芯片客户都对这套新系统表现出极大的热情。目前他们已经购买了多套系统,并为量产追加了订单。”
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读






















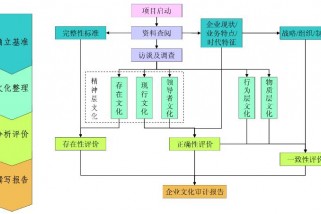












 关注我们
关注我们




