划片是将半导体晶圆分割成单个芯片的过程,一般在晶圆已完成前道工艺制程和电性能测试的基础上进行。同时作为半导体封装的首步工序,划片质量将直接影响封装成品的最终可靠性。砂轮切割是目前应用最为广泛的一种划片方式,采用金刚石颗粒和粘合剂组成的刀片,经主轴联动高速旋转,与被加工材料相互磨削,并以一定速度进给,将晶圆逐刀分割成独立芯片。在工艺过程因残余应力和机械损伤导致的崩裂等缺陷,是制约砂轮划片发展的主要问题。
随着半导体集成电路飞速发展对划片效率和质量的新要求,该切割技术已结合不同加工材料的特点,从划片刀选取、工艺参数优化以及划片方式改进等方面着手,有了一定的发展。面对器件多样化的发展趋势,特别是在超薄晶圆以及含有可动结构的 MEMS 晶圆等非接触划片的发展需求,砂轮划片已无法完全满足。激光切割可有效避免砂轮崩裂问题,同时在小尺寸及 MEMS 芯片方面,凸显出愈发重要的优势,本文将主要对目前主要应用的激光隐形切割和激光烧蚀切割两种划片方式展开讨论。
激光隐形切割技术
芯片分离,是在改质层形成的基础上,通过外力如劈刀施压,或是直接通过扩裂方式,使改质层贯穿于晶圆表面和底面,进而分离成独立芯片的过程。
激光烧蚀切割是利用高能脉冲激光,经光学系统准直和聚焦后,形成能量密度高,束斑尺寸只有微米级的激光束,作用于工件表面,使被照射区域局部熔化、气化,从而使划片间道材料去除,最终实现开槽或直接划透。
激光烧蚀切割以高温为作用机理,在烧蚀边缘会形成被加工材料频繁重铸等现象的热影响区域,如何控制热影响区大小,是实现激光划片在半导体行业发展的主要途径。根据所加工材料对不同波长激光的吸收特性,选择配置相应的激光器和光学系统。其中,脉冲宽度是影响切割质量的重要参数,实指每一个激光单脉冲的持续时间,在功率和频率一致的情况下,脉冲宽度越小,激光与加工材料的作用时间越短,热影响区越小,可降低烧蚀过程对边缘的不利影响。此外,激光器的选取还需兼顾效率和质量,一般激光波长越短,加工热影响区越小,但激光速度偏慢,效率偏低。
目前应用半导体晶圆切割的两类主要激光切割技术,即激光隐形切割和激光烧蚀切割。两种技术各具特点,均展现出传统砂轮划片所无法比拟的优势。随着激光技术的不断发展和相关设备的成熟完善,激光切割将在半导体晶圆切割领域占据更具主导的地位。
来源:中国电子科技集团公司第十三研究所
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读

























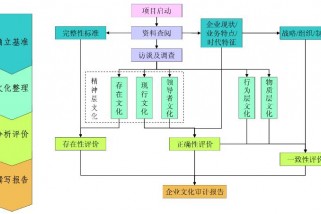








 关注我们
关注我们




