极紫外光刻(EUVL)技术已经酝酿了超过四分之一个世纪,去年第一台EUVL生产工具已经交付客户,芯片制造商和供应商正在试生产线上日趋完善这项技术以备日后的大规模批量生产(HVM)。虽然许多技术和商业领域取得的卓越进展为EUVL进行大规模批量生产做好了准备,但是整个产业可以使EUVL进入真正的HVM阶段还需要解决一些关键的技术和行业挑战。
EUVL技术已经酝酿了超过四分之一个世纪,开拓性的工作发生在20世纪80年代的中后期,并在20世纪90年代致力于研发工作,最终出现了大批产业/国家实验室合作开发(EUV LLC/VNL 项目),首先验证了所有的技术要素,数值孔径为0.1的全视场样机工具。美国半导体制造技术产业联盟(SEMATECH)在20世纪90年代晚期开始EUV项目帮助实现EUVL基础设施。头几年SEMATECH的EUVL基础设施开发重点包括光学元件、光源、EUV抗蚀剂和EUV掩模开发。一旦光学元件和光源于21世纪早期得到了足够的产业动力,SEMATECH 开始通过SEMATECH 抗蚀剂开发中心(RMDC)和SEMATECH 掩模基板开发中心(MBDC)全力开发EUV 抗蚀剂和掩模。到本世纪第一个十年的中期,商业供应商已经建立了全视场EUVL阿尔法工具,在2010 年开始向客户交付测试曝光工具,2013年交付首台产品工具。在21世纪初,EUVL的最初目标是利用100nm,随后产生的问题是:我们现在终于越来越接近将EUVL引向大规模制造了吗?
整个行业快速接近了国际半导体路线图(ITRS)为MPU和DRAM概述的22nm半间距节点。由于EUVL目前不能满足生产要求,领先的设备制造商决定利用多图形193nm沉浸式光刻。然而,如果EUVL在不久的将来满足了生产量和生产率的要求,公司就会借机通过在22nm半间距的选择层内插入EUV实现成本节约,而不选择更加昂贵的MP193i。一旦EUV光源满足了生产要求,还有待观察具体的技术挑战,如光源组件寿命或有益掩模寿命是否会随光源功率而扩大。截至今日,EUV 重点仍然是满足生产要求的同时,掩模产量、缺陷检查/审查基础设施,以及保持使用过程无掩模缺陷,包括EUV防护解决方案,仍然是明确的第二优先级。
EUV光源现状
EUV光源仍然是行业面临的最困难的技术挑战。目前还没有哪家公司能够为光源的可靠性和正常运行时间提供足够高的光源功率和成熟的光源技术,即不能为EUV在大规模生产制造提供可靠稳定的光源。业界的目标是支持22nm节点的EUV HVM,在2014年中间焦点(IF)提供125W输出,2015年提供250W输出。为了实现这一目标,用于产生EUV辐射的CO2激光器的功率就要在测试版的15kW的基础上翻两倍,1064nm波长CO2到13.5nmEUV波长的转换效率至少提高一倍达到~3%。而CO2激光驱动功率大于35kW的只有一个光源供应商,并且需要现场复制。用于调节锡靶的预脉冲技术对于优化转换效率是很重要的,预脉冲将锡液滴优化到目标形状填充泵浦激光器的聚焦光束束腰;预脉冲的波长可以与主脉冲的波长相同。根据不同的设置,预测最大的转换效率可以达到6%。迄今报道的预脉冲系统的最高功率值是50W,最近报道的持续6分钟的最高功率达到70W。
除了满足原始光源功率的目标,光源还需要满足HVM的可靠性和可用性要求。这就需要可以确保光学部件(如收集器、稳定CO2激光器聚焦控制和锡液滴稳定型)长寿命工作的碎片缓解系统。然而在期望的EUV光源功率水平上还没有足够的可利用现场数据来评估EUV光源的可靠性和可利用性将会面临多大的技术挑战,然而,已经表明导入背景气体消除收集器上生长的锡可以使连续激光脉冲生成的冲击波扭曲输入锡液滴导致能量不稳定的液滴轨迹;这个问题也会随着激光功率的增加变得更糟,而在同一时间需要更高的背景气体压力来减轻锡在收集器上的生长。
必须克服高功率EUV光源面临的挑战是很好理解的,而且目前投入了大量的资金来解决这些问题。然而,谁也不能保证这些目标就一定能实现或达到这些预期。过去十年的EUV光源功率预测和技术路线图就证明了我们行业对于预测EUV光源性能发展是很离谱的。如果EUV HVM引入没有发生在16nm节点,目前的工具数值孔径0.33将不能提供足够高的k1值,适用单图层及以下节点。然而,无论是EUV双层图案还是高NA值EUV都要求较高光源功率(EUV双层图案比高NA值EUV稍低一点),因此,从EUV光源角度来看,节点尺寸大于16nm半间距的HVM导入情况可能变得更糟。为了降低这种风险,业界应当推行两种做法:a)对于<1kW的光源,尽量采用驱动电流电源技术,努力使它支持16/11nm节点半间距的EUV;b)对于>1kW的光源,执行应急方案,利用现有的知识/能力建立一个自由电子激光器(FEL)样机。与此同时,我们必须开拓新的自由电子激光器的概念和技术,拓展这种技术规模使其更加实用。
展望
当考虑引入EUVL技术的情况下,我们需要考虑产品的具体要求来了解目前关键参数的状态,如电源功率和掩模基板缺陷。下图突出了行业的当前状况,并显示了开始使用EUVL的光源功率和掩模基板缺陷水平。图1是一个简化示意图,但它表达了一个重要信息,逻辑制造商以及他们的代工企业是最有可能率先启动EUVL的。在逻辑制造商之间,代工企业在他们目前的商业模式扩展多个图案是很困难的,因为他们必须迁就所有客户的设计空间,而一个独立的设备制造商可以控制设计、技术和制造一系列过程,比代工厂可以进一步推动特定技术。
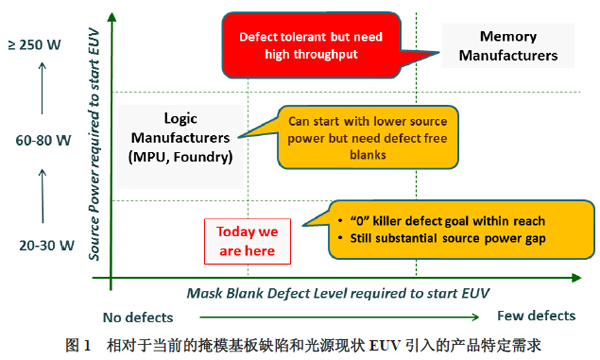
所有上述引发了一个问题:EUV到底要延迟多久?答案很简单:不再延迟了。EUV最初是针对更大节点(21世纪初的70nm 特征尺寸),现在是接近错失的10nm节点。如果错过了10nm节点,那么只剩下一个节点,目前的一代工具可以支撑使用单图案:随着目前0.33NA一代工具引入EUVL,7nm节点是最后的单图案节点。对于更小的节点,人们必须考虑双重图案或者在采用双图案之前转移到更高NA的一代极紫外光刻工具保持单图案在两个节点上。
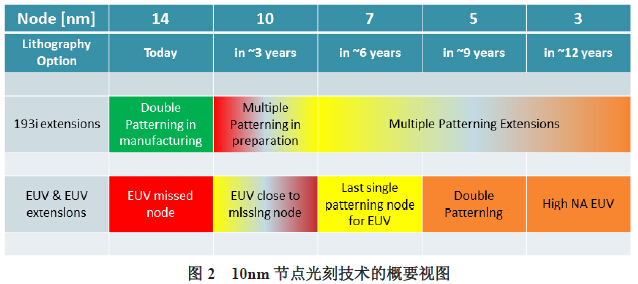
尽早引入EUVL的推动因素是多图案的高成本和复杂性。多图案已经成为10nm节点的一个现实,大部分公司都可能在7nm节点采用多图案方案,即使外观看起来不美观。将多重图案在10nm或7nm节点的假设成本与今天EUVL 技术的预计成本相比较会遗漏一个重要的、有助于降低多重图案成本的参数,即工程师的聪明才智会不断改善方案,利用工具推动图案成本降低,如定向自组装(DSA)。因此,EUV技术需要把目标定在10nm节点生产上,尽快从相同的制造优先选项获取利益,通过整个制造产业链来推动成本降低。如果EUVL没有在10nm节点被领先优势的制造商引入,EUVL将面临在7nm节点引入的非常高的障碍。
EUVL降低了设计和工艺复杂程度,EUV HVM工具产生的第一幅印刷图像展示了预期图像质量,然而业内人士正在等待,看看客户端的第一生产工具的可靠性数据和产量提高是否能达到预期。虽然在关键的掩模基础设施挑战上,如掩模基板无缺陷,取得了重要进展,设施的其他部分的挑战仍然存在,如商用EUV防护解决方案,包括一个兼容的EUV掩模工具设备不会使用很多年。如今引入EUV制造主要是受到持续生产力挑战的阻碍。关键的是这些生产率的挑战很快就会解决,芯片制造者可以开始制造学习10nm节点并且在7nm节点插入技术。虽然目前EUVL被认为是能够满足半导体产业需求、显著降低成本的唯一技术,但是如果在降低双重图案成本或者针对特定产品的竞争技术成为可能的情况下,上述图表或许会发生变化。#p#分页标题#e#
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读

























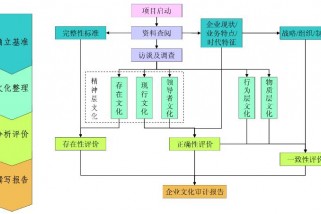








 关注我们
关注我们




