摘要:由于需以各种非金属半导体材料晶圆制造使用价值低之微电子产品,对其加工高精度及品质改善的要求更为严苛,因此研究效率高的晶圆切割方法有其必要性。本文将探讨得以加工昂贵复杂之装置的高效晶圆切割法,笔者透过实验证明应用激光控制热裂解法的效果,提出将该方法导入玻璃、硅、蓝宝石及其他脆性非金属材料精密切割的优势与成果。
关键词:微电子产品;激光切割半导体材料;激光切割晶圆;激光切割玻璃;激光控制热裂解法(韩卓申科切割法)
俄罗斯科学与创新发展的趋势为对微米和纳米技术领域之研发,并将其结果导入生产。
由于现代电子产品发展突飞猛进,使仪器和工艺设备尺寸缩小。微米和纳米技术与制造微米、纳米物体的方法直接相关,其尺寸至少在一个维度上不大于100µm或100nm。为制造以微米和纳米技术为基础之电子产品,采用的是经充分验证之材料及新材料,拥有广大潜力能为特定应用取得可控制、有利的物理化学性质。
用于生产半导体器件之传统晶圆材料均属脆性,而印刷其上的结构因物理特性加深后续生产制程难度。此外,精密器件加工复杂促使收益增加、开发更为繁复的结构,并优化半导体晶圆有效区域之应用,同时又要维持售价与运营成本。
目前将晶圆分离成芯片的主要技术皆建立于机械与激光切割基础上,即钻石划线后裂片、带外刀刃的钻石圆盘锯片切割、激光划线后裂片、激光切割等。
本文分析非金属材料晶圆的切割技术和方法,阐述芯片品质研究结果,并特别着重激光控制热裂解(Laser Controlled Thermal Cracking,以下簡稱LCT)[1-4]及其在制造各式电子产品的应用[5]。
1 现有晶圆切割技术与设备分析
首先探讨钻石划线后裂片,以及带外刀刃的钻石圆盘锯片切割。
半导体晶圆机械划线直至1990年代未曾改变[6],刀具有硬质合金刀轮、三角锥或四角锥台等形式,皆以鑽石及其他硬質合金製成,因其耐磨性最佳。機械劃線用角錐的稜劃線,輪流標示刻槽,此法的应用受限于有如应力集中系数k之标准,透过施加弯矩决定在表面的最大弯曲应力,可经下列公式计算:
k = (0.355 (t - d) / r) + 0.85) / 2 + 0.08 | (1) |
其中,t:晶圆厚度;d:切割深度;r:钻石粒径。
由此可知,晶圆愈厚所需的弯曲应力愈大。可透过增加划痕深度减少所需的弯曲应力,但如此沿切割线的缺陷程度便会增加,且划线工具上压力提高可能导致材料分裂不受控制;另可加大钻石粒径,但同样会影响芯片断面品质及其机械强度。
半导体晶圆机械划片和分割的设备厂商有法国JFP及Cefori、台湾爱玻丽工业、英国Loadpoint等公司。
在生产中最简易的晶圆切割法为钻石圆盘锯片切割。当切割深度不超过1.5 mm,可使用带外刀刃的钻石圆锯片将晶圆切割分离成芯片[7]。有时采用间隔距离与欲切割芯片尺寸相等的锯片组,或用配备双轴之机器。根据不同任务,圆盘厚度为0.02~0.32 mm(20~320 µm)不等。钻石圆盘切割之目的旨在实现宽度20 µm的锯痕,然而,却更常出现宽度达250 µm的锯痕,关键在于刀片材料、钻石颗粒粒度和密集度、旋转与切割速度等众多因素。
带外刀刃的钻石圆盘锯片切割缺点为刀具硬度G不高,该部分主要取决于其尺寸(含厚度和外径)的比例,而硬度与主要操作因素相关,如下列关系式:
 (2)
(2)
其中,Km:(用来说明材料性质的)系数;W:转数;Vcut:切割速度;m, n:常数。
强化刀具硬度的方式有二:其中一种为采用厚切割锯片,但将加大锯口宽度并增加材料损失;另一种则为提高切割锯片转速,此时产生之离心力会给予额外的硬度,但随着转数增多,锯片刀刃产生振动,流体力学过程加强,也会导致切割区域缺陷数量、大小皆增加。
制造切割晶圆的外刀刃钻石圆盘锯片设备和工具厂商有:ESTO(俄罗斯)、PLANAR(白俄罗斯)、Loadpoint(英国)、ADT先进切割科技(以色列)、迪思科及东京精密(日本)等。
相较于机械法,透过激光划线及切割晶圆的方法仍处于发展阶段。随着晶圆直径加大、激光器更为便宜且产能增长,其生产优势也显著提升。
本文将探讨激光切割晶圆的许多研究,包含使用具有各种波长范围辐射[8, 9]、不同脉冲宽度(飞秒、皮秒至纳秒[10-13])与功率之激光。惟上述加工皆未将切割厚度200µm以上的晶圆列入考虑。
已确知脉冲频率愈高,切割速度愈快,为材料内部能量分布增加所致。然每一发脉冲烧蚀深度的增加会引发如熔化、裂纹、非晶化和残余应力积累等热影响。将晶圆分离为芯片时,这些热影响导致芯片强度降低,损坏表层薄膜与敏感的电子器件。
激光划线时,切割道宽达2.5~100 µm,取决于辐射源、光学仪器及其他辅助系统;而速度变化可在5~300 mm/s范围内,决定性因素为加工材料之性质、厚度及其他参数。为顺利对划线后之材料进行机械劈裂,划线深度必须超过材料厚度的30%,例如,日本迪思科公司官网即有激光划线和激光切割非金属材料设备介绍[14]。
有一项新技术是用激光透过热冲击对材料引起可控制的破坏。约莫13年前,由日本滨松公司开发出来并取得专利之「隐形切割法」在晶圆切割实际应用上前景可期。此方法是将部分透明的激光光斑聚焦在板材内部接近晶圆表面之处,并沿着预定方向对材料引发可控制的破坏。当材料内部具备的功率密度足够,会形成一条微裂纹、点缺陷的线,与制作纪念品的玻璃半成品内部3D激光打标雷同[15],且如同任一种划线法,施加内部缺陷后必须再进行劈裂作业。
原则上隐形切割法因具备速度快、零污染、切割宽度近乎为零等优点,而被视为理想的晶圆切割解决方案。据各方资料显示,隐形切割速度可高达600 mm/s,关键因素在于材料及其厚度、激光器功率参数。
2 激光控制热裂解法(LCT法、韩卓申科切割法、Kondratenko切割法)
80年代范德米尔.史戴潘诺维奇.韩卓申科教授在苏联发明LCT法[16],过去用于制造光电子玻璃产品。然而,近十年多种脆性非金属材料的激光控制热裂解法迅速发展,并应用在各科技领域。许多关于LCT法应用的出版品,以及发展该方法与制造成套工艺设备的专利[1-4]皆可证实该论点。
LCT制程基础是激光光斑沿晶圆切割线进行加热,随后再以致冷剂冷却受热处。激光辐射照射材料表面会使外层产生显著的压缩应力,但不会造成断裂。正因致冷剂促使局部剧烈冷却,所形成之温度梯度导致表面层产生拉伸应力,才得以使裂纹推进(如图1)。
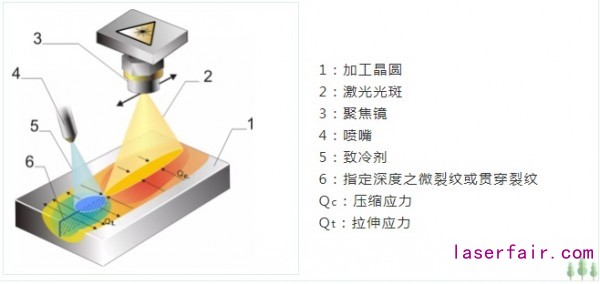
图1 以LCT法生成微裂之示意图
加热和冷却之选配旨在于指定深度(占晶圆厚度10~50%处)形成微裂纹,或是直接切穿。此外,相较于传统方法,切割速度也提高了多个数量级──厚度较薄的产品速度更可能超过1000 mm/s;由于前述性能,全世界首次将激光切割导入浮法玻璃之生产[17,18]。浮法玻璃系指铺在锡液表面上的熔融玻璃,全球多达80%平板玻璃皆以该方式制成,其切割通常采机械法,所形成之微裂纹及其他缺陷致使强度下降50~60%。
LCT法除了生产效率极高、绝无缺陷(裂纹或缺口)之外,强度亦高于传统方法五倍之多[19, 20]。材料不论厚薄均能以LCT技术切割,如厚达20 mm之玻璃或仅50μm之薄蓝宝石晶圆[21-23]品质均优。无论直线或异形切割,铌酸锂、钽酸锂、碳化硅、砷化镓、微晶玻璃、陶瓷、玻璃、石英或甚至钻石的断面皆相当完美及平滑[24]。由于毫无缺陷,也便不需保留余量以处理刀具遗下之缺陷。如由莫斯科厂蓝宝石开放式股份公司生产的RT-350和RT-500激光控制热裂解设备[25-27]用于晶圆切割,即为实现此方法之一例。
运用LCT法切割脆性材料时,边缘强度比机械或激光划线高出5~5.5倍,且不会对集成电路的技术操作参数产生负面影响[28-30]。相对于传统切割法无疑具有极大优势,但以LCT法沿交叉线切割有一定难度。LCT后高强度、无缺陷的晶圆断面阻止裂纹在原切割线相交处推进,因而开发出得以克服此限制之方案,并获取专利权[3, 4]。
韩卓申科教授是鸿海科技集团的科学顾问,该集团为生产苹果公司电子产品及旗舰小配件的全球领导者。利用LCT法开发切割玻璃及蓝宝石产品的技术设备为其主要合作方向。鸿海科技集团2007年即成立研究生产车间,后发明以万用技术设备执行异形激光切割和双面倒角的制程[31-33],用于与苹果公司iPhone、iPad和iMac等移动设备相似的防护屏(如图2)。

图2 移动设备防护屏
俄罗斯绿城TM激光和设备公司根据与专利权人签订之许可协议,导入在俄应用LCT技术所累积的经验。2014年出产之MLP1-1060/355试生产设备(如图3)即适用于蓝宝石与其他脆性非金属材料晶圆LCT切割[34]。
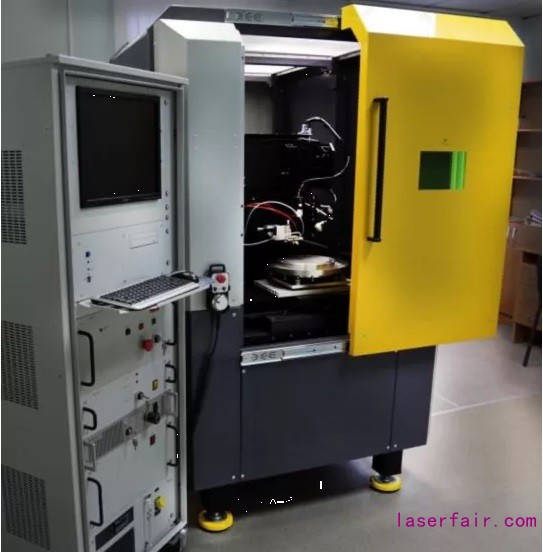
图3 俄罗斯设备MLP1-1060/355
取LCT法切割晶圆后所得之蓝宝石芯片断面照片进行比较(如图4),可见LCT明显优于其他熟知的竞争技术;其切割速度介于30~500 mm/s间,视蓝宝石厚度(30~1000 μm)而定。一般来说,蓝宝石在一个工艺周期内即一刀切穿,仅在某些情况下会于占材料厚度10~30%处先行作出初始微裂,再以激光或机械劈裂完成切割,如蓝宝石防护屏闭环切割便建议依前述方式操作。
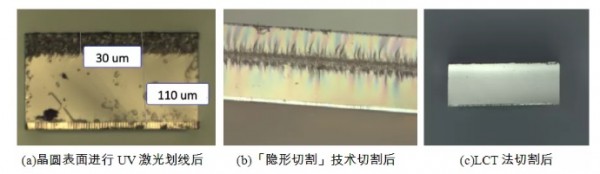
图4 厚110μm的蓝宝石芯片断面
接续探讨以LCT法解决有机发光二极体(Organic Light Emitting Diode,以下簡稱OLED)硅晶圆切割质量的问题,尤以生产微型显示器为主[8, 35-37]。以玻璃基板封装并带有OLED的切割用硅晶圆成本相当高。
OLED微型显示器领域的先驱有eMagine(美国)、索尼(日本)、MicroOLED(法国)、奥雷德(中国)和TOPE Ltd.(俄罗斯)等制造商,采行传统方法将硅晶圆切割成芯片,然即便最佳工艺参数也无法对OLED芯片进行品质管理,因而借助LCT开发新的激光切割法,可由反面加工用防护玻璃封装之硅晶圆。以感光度范围介于1460~1625 nm(硅透射率»55%)的红外线摄像机沿切割线瞄准,以便识别硅晶圆工作面上用于对位的参考标记。硅经韩卓申科切割法一刀切穿后OLED结构不会受损[38,39],切割时不致过热,断面光滑,而边缘也毫无缺陷。
将钻石圆盘锯片及LCT切割后之芯片断面品质进行比较,并以型号XP-200的Ambios(美国)表面光度仪测量芯片工作断面的表面粗糙度(如图5),锯片切割后为Rа= 23.407 μm,而LCT后则不大于Rа~0.005μm。

图 5 芯片断面照及其表面轮廓图
3 结论
将LCT法导入生产以半导体晶圆为基底的防护屏、显示面板和现代电子产品等制程,可提高生产率及合格率。此成果来自LCT法相对于竞争技术之主要优势,即:
(一) 沿切割线无缺陷,可由粗糙度值证明,通常超越竞争对手多个数量级。
(二) 由于边缘无缺陷,与传统技术相比,LCT之后产品机械强度高出5倍之多。
(三) 制程速度快,实际能力较其他方法高出数倍。
(四) 晶圆工作表面上各元件和结构不会恶化或改变。
如今,韩卓申科切割法创始人及支持者持续在各行业和研究中将此技术发扬光大,如英属开曼群岛商纳诺股份有限公司便致力于各种脆性非金属材料切割技术,以及新一代设备之开发、拓展与导入。
1俄罗斯科技大学物理与技术学院光学暨生物工程系统与技术教研室,莫斯科 107996
E-mail:vsk1950@mail.ru
2国际技术科学院,莫斯科 127051
3有机和印刷电子技术股份有限公司,莫斯科 107497
E-mail:ivi061@gmail.com
4英属开曼群岛商纳诺股份有限公司材料激光加工实验室,台北11493
E-mail: jasber@nanoplustech.com(吕鸿图)
lasercutan@163.com(纳乌莫夫 A S)
wynadya@nanoplustech.com(王薇媛)
参考文献:
[1] [俄]韩卓申科VS. 非金属材料切割法:俄罗斯联邦,2024441[P].1992-04-02.
[2] [英]韩卓申科VS. 非金属材料切割:国际专利,WO93/20015[P].1993-10-14.
[3] [俄]韩卓申科VS. 脆性非金属材料切割法(延续性专利):俄罗斯联邦,2206528[P].2001-08-15.
[4] [俄]韩卓申科VS,纳乌莫夫AS.脆性材料晶圆切割法:俄罗斯联邦,2404931[P].2009-08-28.
[5] [俄]韩卓申科VS.创新项目商业化[J].机器制造的节奏,2016,1:50.
[6] [俄]尼基芙罗娃-丹尼索娃SN.机械及化学加工:半导体器件及微电子产品技术第四册[M].莫斯科:高等学校,1989:96.
[7] [俄]库尔诺索夫AI,尤金VV.半导体器件与集成电路生产技术:「半导体及绝缘体」和「半导体器件」专业高等学校教材[M].3版,改写增订版.莫斯科:高等学校,1986:368.
[8] [俄]伊万诺夫VI.用于生产有机发光微型显示器的硅晶圆切割法[J/OL].科学学,2014,4(23). http://naukovedenie.ru/PDF /87TVN414.pdf.
[9] [英]曾XJ,毛X,格里夫R,等.硅的紫外飞秒和纳秒激光烧蚀:烧蚀效率和激光诱导等离子体膨胀[C/OL]//克劳德RP.高功率激光烧蚀V:光电仪器工程师协会论文集.第5448卷.2004. http://dx.doi.org/10.1117/12.544401.
[10] [英]博瓦茨J,帕特尔R.以纳秒脉冲355nmQ开关激光源及线聚焦注量优化技术进行薄硅晶圆高速切割[C/OL]//弗雷金 W,吕 Y,鹫尾 K,等.以激光为基础的微米和纳米级封装及组装IV:光电仪器工程师协会论文集.第7585卷.2010. http://dx.doi.org/10.1117/12.845298.
[11] [英]邦斯J,鲍达奇S,克鲁格J,等.硅的飞秒激光烧蚀--变质阈值与型态[J/OL].应用物理学A辑.2002,74:19–25. http://link.springer.com/article/10.1007/s003390100893.
[12] [英]拉邱凯提斯G,布里卡斯M.硅和玻璃的皮秒激光微加工[C/OL]//宫本I,赫尔瓦简H,伊藤K.第五届激光精密微加工国际研讨会:光电仪器工程师协会论文集.第5662卷.2004:717. http://dx.doi.org/10.1117/12.596604.
[13] [英]克洛茨巴赫U,潘兹纳M,卡斯珀J,等.以掺钕钇铝石榴石激光及谐波成像加工硅[C/OL]//杜博夫斯基JJ,霍文W,杉冈K,等.微电子学与光子学中的光子处理:光电仪器工程师协会论文集.第4637卷.2002:496. http://dx.doi.org/10.1117/12.470659.
[14] [英]迪思科高科技股份有限公司.产品信息[OL].[2018-10-29].http://www.disco.co.jp/eg/products/laser/index.html.
[15] [英]滨松公司.隐形切割技术及应用[OL].2005[2018-10-29].
[16] [俄]韩卓申科VS. 切割平板玻璃的方法:俄罗斯联邦,776002[P].1979-02-19.
[17] [俄]韩卓申科VS,鲍里索夫斯基VE,金丁PD.浮法玻璃激光切割技术开发与应用[J].莫斯科国立仪器工程与电脑科学大学学报,2006,7:73–81.
[18] [俄]韩卓申科VS,日马洛夫AB,索利诺夫VF,等.浮法玻璃制程中的激光切割[J].玻璃与陶瓷,2006,10:3–5.
[19] [俄]韩卓申科VS,索利诺夫VF,塔纳谢楚克AS,等.以各种方法激光加工玻璃边缘的产品强度[J].电子业,1988,1(69):30–31.
[20] [俄]韩卓申科VS,柯比什NI,纳乌莫夫AS,等.玻璃边缘加工法对产品强度之影响[C]//科学、技术与教育当中的创新工艺:国际科学技术会议论文集.莫斯科:莫斯科国立仪器工程与电脑科学大学,2009:60–65.
[21] [俄]韩卓申科VS,马什维奇PR,米纳耶夫VV.蓝宝石晶圆激光控制热裂解[C]//电子系统耐辐射性能:科技论文集.莫斯科:国立核能研究大学莫斯科工程物理学院,2009,12:228.
[22] [俄]韩卓申科VS,纳乌莫夫AS.蓝宝石晶圆激光切割新技术[J].仪表设备,2011,10(136):37–41.
[23] [英]韩卓申科VS,鲍里索夫斯基VE,纳乌莫夫AS.蓝宝石晶圆激光切割新技术[J].先进材料研究,2013,660:30–34.
[24] [英]韩卓申科VS,鲍里索夫斯基VE,纳乌莫夫AS.优化异形切割玻璃激光控制热裂解之参数[J].光学与光子学杂志,2015,5(10):295–302.
[25] [俄]韩卓申科VS,鲍里索夫斯基VE,纳乌莫夫AS,等.晶圆激光切割机[J].仪表设备,2006,4(70):38–43.
[26] [俄]韩卓申科VS,金丁PD,科列斯尼克VD,等.半导体晶圆激光切割机RT-350[C]//科学、技术与教育中的创新工艺:国际科学技术会议论文集.莫斯科:莫斯科国立仪器工程与电脑科学大学,2009:9.
[27] [俄]韩卓申科VS,金丁PD,纳乌莫夫AS,等.RT-500玻璃激光切割机[C]//科学、技术与教育中的创新工艺:国际科学技术会议论文集.莫斯科:莫斯科国立仪器工程与电脑科学大学,2009:10.
[28] [俄]沙夫鲁克NV,马尔切夫PP,韩卓申科VS,等.厚300 µm以上的蓝宝石晶圆切割[C]//第六届物理与纳米异质结构超高频电子学技术国际科研实用会议「马克罗夫纪念讲座」论文集.莫斯科:国立核能研究大学莫斯科工程物理学院,2015:54–55.
[29] [俄]甘克雷利兹SA,韩卓申科VS,斯帝蓝VV,等.已开发之蓝宝石及碳化硅晶圆切割基本方法对单片超高频氮化镓集成电路良率的影响[J].应用物理学的成就,2017,1:80–85.
[30] [俄]甘克雷利兹SA,韩卓申科VS,斯帝蓝VV,等.蓝宝石和碳化硅晶圆切割法对单片集成电路技术操作参数之影响[J].仪表设备,2017,1:43–50.
[31] [俄]韩卓申科VS,鲍里索夫斯基VE,纳乌莫夫AS,等.玻璃产品锋利边缘激光钝化新技术[C].「玻璃的发展-XXI」国际科学技术会议论文集.萨拉托夫:[出版者不详],2008.
[32] [俄]韩卓申科VS,纳乌莫夫AS.钝化产品锋利边缘的方法:俄罗斯联邦,2426700[P].2011-08-20.
[33] [英]韩卓申科VS.,金丁PD,特鲁比延科OV,等.玻璃边缘的激光强化[J].光学技术杂志,2009,76(11):733–736.
[34] [俄]韩卓申科VS,纳乌莫夫AS,吕鸿图.蓝宝石晶圆精密激光切割技术[J].光子学,2015,2(50):42–52.
[35] [俄]韩卓申科VS,鲍里索夫斯基VE,伊万诺夫VI.激光控制热裂解法对硅晶圆上有机发光二极体之分割[J].防御系统--俄罗斯科技发展,2014,2:76–81.
[36] [俄]韩卓申科VS,鲍里索夫斯基VE,伊万诺夫VI,等.有机发光二极体硅晶圆激光切割工艺效能之提高[J].仪表设备,2015,9(183):49–55.
[37] [俄]韩卓申科VS,伊万诺夫VI.硅晶圆切割方法对有机发光二极体品质的影响[J].应用物理学,2017,1:36–40.
[38] [俄]韩卓申科VS,伊万诺夫VI.对带有机发光结构之硅晶圆从非工作面进行激光切割的新方法[C]//韩卓申科VS.光学技术、材料和系统:莫斯科科技大学物理技术研究所会议论文集.莫斯科:莫斯科科技大学,2017:52–58.
[39] [俄]韩卓申科VS,伊万诺夫VI.切割晶圆的现代方法与设备(综述)[J].应用物理学进展,2018,6(2):174-183.
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读

























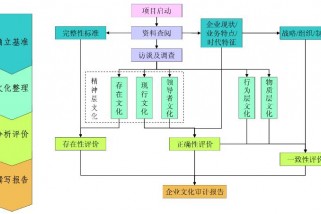








 关注我们
关注我们




