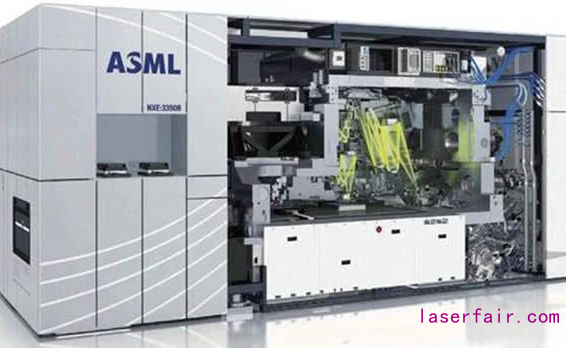
在2018年末,三星和台积电推出了具有5至7个EUV层的7nm晶圆代工逻辑工艺,两家公司在整个2019年也都加快了这些工艺的生产,现在正在大量生产中。进入今年,三星和台积电都在加快具有12至14个EUV层的5nm晶圆代工逻辑工艺的进度,而英特尔正在研究明年有望基于EUV的7nm工艺。英特尔的7纳米制程密度应与三星和台积电的5纳米制程相当。
三星还于2019年末推出了其1z DRAM工艺,该工艺最初是光学的,但随后过渡到单个EUV层。2020年3月下旬,三星宣布已出货100万个基于EUV的DRAM模块。三星的下一代DRAM工艺,即所谓的1c代DRAM有望具有4个EUV层。
显然,EUV已被公认为是领先逻辑和DRAM生产关键层的最佳解决方案。
而在今年的SPIE高级光刻会议,ASML的Mike Lercel展示了公司EUV的四个方面:
1、当前的生产是使用0.33NA系统完成的,ASML给出了这些系统的当前状态和路线图。2、EUV源是系统的关键组成部分,并描述了新的改进源的详细信息。3、生产0.5NA系统以提高分辨率和生产率的工作状况。4、ASML收购了HMI,并将继续开发其多光束– Ebeam晶圆检测技术。
0.33NA系统
关于这方面,ASML的总结如下图所示:
截至2019年底,ASML已交付了53套系统,并且在该领域已曝光超过1000万片晶圆。图2展示了按季度分列的发货系统和曝光的晶圆。
图2
图2的一个特别令人印象深刻的方面是背景照片,该照片显示了在未公开客户现场安装的成排的EUV系统。该领域的当前系统是NXE:3400B,该系统现在已经证明一周平均每天> 1,900 wpd,最好的一天超过2,700 wpd。图3说明,平均可用性现在已达到85%,而系统的前10%则为90%。90%一直是3400B系统的目标,ASML继续努力将3400B系统的可用性提高到90%左右。
图3
ASML现在已经开始交付下一代系统NXE:3400C。NXE:3400C具有改进的光学性能和机械吞吐量,与3500B相比,新机器在在20mJ/cm 下可获得每小时160片晶圆(wph)的效率,在30mJ/cm2下则能获得135 wph的效率,那就意味着吞吐量提高了约20%。
在3400B,设备的指定为20mJ/cm 用于生产量,而30mJ/cm 则是因为需要随着特征尺寸的缩小而增加。作者注意到,我相信即使对于7nm晶圆代工逻辑,目前的数字仍高于30mJ/cm 。
3600C对系统进行了几处改进,以提高可用性。据相关数字透露,他们的目标是将其可用性提高到95%,这将与DUV系统所达到的可用性相同。这些改进将在源代码的论文中进一步讨论。
ASML预计在2021年中期以30mJ/cm 交付具有160 wph吞吐量的NXE:3600D,并且更长期地计划推出以30mJ/cm 达到220wph的系统。吞吐量不断提高的关键是更高的光源功率(请参见EUV光源部分)和更快的机械处理。在不断提高dose准确性,覆盖(overlay),CD均匀性(uniformity )和聚焦均匀性(uniformity )的同时,实现了这些吞吐率的提高。
EUV光源3400B系统上最大的可用性损失原因是液滴产生器和收集器反射镜,见图5。
图5
3400C系统通过自动重新装锡发生器,快速更换墨滴喷嘴(droplet nozzle)和方便检修门以快速更换收集器镜(mirror swaps)来解决这些问题。
聚光镜的寿命也在不断提高,而功率也在增加。
这些改进的最终结果是在现场将3400C系统的正常运行时间目标定为95%。为了实现吞吐量的不断提高,ASML将继续提高电源功率。图8说明了电源功率的趋势。请注意,从研究到大批量生产的时间大约为2年,因此我们可能会在2022年左右看到500瓦的电源(目前的电源大约为250瓦)。
0.5NA系统曝光系统的分辨率与NA成反比。随着关键尺寸的缩小,0.33NA EUV系统将需要multi-patterning才能印刷出最小的特征。高NA系统的目标是使0.33NA系统的覆盖率和生产率匹配,同时使单程光刻技术扩展到更小的特征。0.5NA系统的光学系统是变形(anamorphic)的,即在一个方向上的放大倍数为4x,在正交方向上的放大倍数为8y。这导致场大小是具有相同标线片大小的4x/4y系统的场大小的1/2。为了实现高生产率目标,掩模台的加速度是0.33NA系统的4倍,晶圆台的加速度是0.33NA系统的2倍。
快速阶段中传输的改进导致在相同吞吐量下,0.55NA系统比0.33NA系统的吞吐量有所提高。这里应该注意,为0.55NA系统开发的一些高速sateg技术正在0.33NA系统上实现,以进一步提高这些系统的吞吐量。
目前,ASML正在实现晶圆和掩模台加速并最终确定架构。这与0.33NA系统的主要区别在于新的光学系统和更快的stage,尽管更快的stage技术再次用于0.33NA系统。0.55NA系统还需要更好的对准和水平度。ASML当前正在测试特定配置,以确定高加速度下的颗粒生成,并开始收集一些第一批传感器数据。ASML还在世界各地的各种设施中构建0.55NA系统的基础架构。
1、康涅狄格州的ASML Wilton负责标线阶段。
2、系统将在荷兰Veldhoven的ASML总部组装。
3、德国Oberkochen的Ziess负责光学制造。
4、光源是加利福尼亚圣地亚哥的ASML负责。
目前公司有4个系统在订购中,预计将在2022/2023年的时间范围内可用。
多光束EBeam
ASML收购了HMI,并继续追求HMI多光束EBeam曝光技术。电子束检查具有很高的分辨率,但检查0.1%的芯片大约需要2个小时,非常缓慢。
多光束方法利用3x3阵列中的9个光束同时扫描。图11说明了基本工具概念。
现在,ASML已证明光束之间的串扰小于2%,并且他们正在利用DUV曝光工具中的stage技术来提高多光束系统的通量。他们的目标是将吞吐量提高5-6倍,并且长期使用25光束系统。毫无疑问,EUV现在是用于领先工艺的关键光刻的首选解决方案。ASML继续展示当前的0.33NA生成系统和下一代0.55NA系统的开发进展。
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读





















 关注我们
关注我们




