MEMS(Micro-Electro-Mechanical System)即微电子机械系统,一般由微机械结构、微传感器、微执行器和控制电路组成,MEMS是通过半导体工艺实现不同能量形式之间的转换的一种芯片。根据能量转换形式的不同,一般分为传感器和执行器两类,传感器即感测到外界信号并将其转换成所需的信号(一般是电信号)进行处理,应用有:惯性传感器、硅麦克风等;执行器即将控制信号(一般是电信号)转化为其他形式的能量(一般是机械能)输出,应用有:光学系统、RF MEMS等。
MEMS的制造主要采用Si材料,它与IC的不同在于,IC是电信号的传输、转换及处理,而MEMS是电信号和其他形式能量间的转换(以机械能为典型),所以在MEMS制造中往往需要利用半导体工艺在Si上制作悬梁、薄膜、空腔、密封洞、针尖、微弹簧等复杂的机械结构,这些微机械结构容易因机械接触而损坏、因暴露而沾污,能承受的机械强度远远小于IC芯片。基于这样的特点,MEMS晶圆的划片方法不同于典型IC的划片。典型IC砂轮划片是通过砂轮刀片高速旋转来完成材料的去除,从而实现芯片切割。由于刀片的高速旋转,往往需要使用纯水进行冷却和冲洗,那么刀片高速旋转产生的压力和扭力,纯水的冲洗产生的冲击力以及切割下来的Si屑造成的污染都容易对MEMS芯片中机械微结构造成不可逆的破坏。所以典型IC的砂轮划片不适用MEMS晶圆的划片。
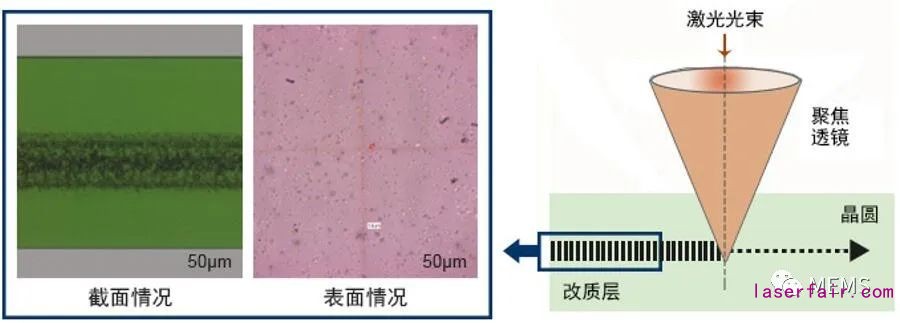
图1 激光隐形切割在玻璃中的应用切割示意图
激光隐形切割作为激光切割晶圆的一种方案,很好的避免了砂轮划片存在的问题。如图1所示,激光隐形切割是通过将脉冲激光的单个脉冲通过光学整形,让其透过材料表面在材料内部聚焦,在焦点区域能量密度较高,形成多光子吸收非线性吸收效应,使得材料改性形成裂纹。每一个激光脉冲等距作用,形成等距的损伤即可在材料内部形成一个改质层。在改质层位置材料的分子键被破坏,材料的连接变的脆弱而易于分开。切割完成后通过拉伸承载膜的方式,将产品充分分开,并使得芯片与芯片之间产生间隙。这样的加工方式避免了机械的直接接触和纯水的冲洗造成的破坏。目前激光隐形切割技术可应用于蓝宝石/玻璃/硅以及多种化合物半导体晶圆。
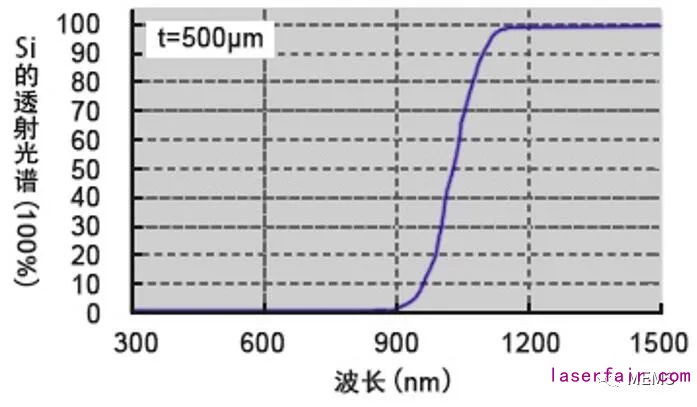
图2 硅材料透射光谱的特性
硅材料透射光谱的特性,见图2,硅材料对红外透过率很高,所以硅的隐形切割设备,通过选用短脉冲红外激光器,将激光脉冲聚焦到硅衬底内部,实现隐形切割。激光隐形切割是非接触式切割,解决了砂轮切割引入外力冲击对产品破坏的问题。不过一般设备的激光隐形切割形成的改质层区域会使材料变得酥脆,还是会形成少量细小硅碎屑掉落,虽然碎屑数量远少于砂轮切割,如前文所述,MEMS晶圆因为无法通过清洗的方法去除细小硅碎屑,故这些碎屑将对芯片造成破坏,影响良率。德龙激光生产的硅晶圆激光切割设备,见图3,选用自制的红外激光器和自主开发的激光加工系统,实现硅晶圆的隐形切割,该设备能够很好的控制隐形切割后碎屑的产生,从而满足高品质MEMS晶圆切割的要求,保证切割良率。德龙激光的硅晶圆激光切割设备自推向市场后,得到了国内多家量产客户的认可和好评,设备在多个MEMS制造厂内批量切割诸如硅麦克风/电热堆/陀螺仪等MEMS产品。实物切割效果图见图4。

图3 德龙硅晶圆激光切割设备外观图

图4 MEMS产品切割效果图
来源:MEMS公众号
MEMS(Micro-Electro-Mechanical System)即微电子机械系统,一般由微机械结构、微传感器、微执行器和控制电路组成,MEMS是通过半导体工艺实现不同能量形式之间的转换的一种芯片。根据能量转换形式的不同,一般分为传感器和执行器两类,传感器即感测到外界信号并将其转换成所需的信号(一般是电信号)进行处理,应用有:惯性传感器、硅麦克风等;执行器即将控制信号(一般是电信号)转化为其他形式的能量(一般是机械能)输出,应用有:光学系统、RF MEMS等。
MEMS的制造主要采用Si材料,它与IC的不同在于,IC是电信号的传输、转换及处理,而MEMS是电信号和其他形式能量间的转换(以机械能为典型),所以在MEMS制造中往往需要利用半导体工艺在Si上制作悬梁、薄膜、空腔、密封洞、针尖、微弹簧等复杂的机械结构,这些微机械结构容易因机械接触而损坏、因暴露而沾污,能承受的机械强度远远小于IC芯片。基于这样的特点,MEMS晶圆的划片方法不同于典型IC的划片。典型IC砂轮划片是通过砂轮刀片高速旋转来完成材料的去除,从而实现芯片切割。由于刀片的高速旋转,往往需要使用纯水进行冷却和冲洗,那么刀片高速旋转产生的压力和扭力,纯水的冲洗产生的冲击力以及切割下来的Si屑造成的污染都容易对MEMS芯片中机械微结构造成不可逆的破坏。所以典型IC的砂轮划片不适用MEMS晶圆的划片。
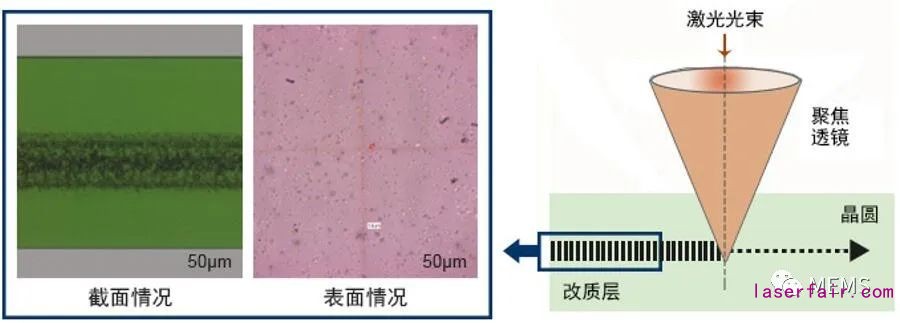
图1 激光隐形切割在玻璃中的应用切割示意图
激光隐形切割作为激光切割晶圆的一种方案,很好的避免了砂轮划片存在的问题。如图1所示,激光隐形切割是通过将脉冲激光的单个脉冲通过光学整形,让其透过材料表面在材料内部聚焦,在焦点区域能量密度较高,形成多光子吸收非线性吸收效应,使得材料改性形成裂纹。每一个激光脉冲等距作用,形成等距的损伤即可在材料内部形成一个改质层。在改质层位置材料的分子键被破坏,材料的连接变的脆弱而易于分开。切割完成后通过拉伸承载膜的方式,将产品充分分开,并使得芯片与芯片之间产生间隙。这样的加工方式避免了机械的直接接触和纯水的冲洗造成的破坏。目前激光隐形切割技术可应用于蓝宝石/玻璃/硅以及多种化合物半导体晶圆。
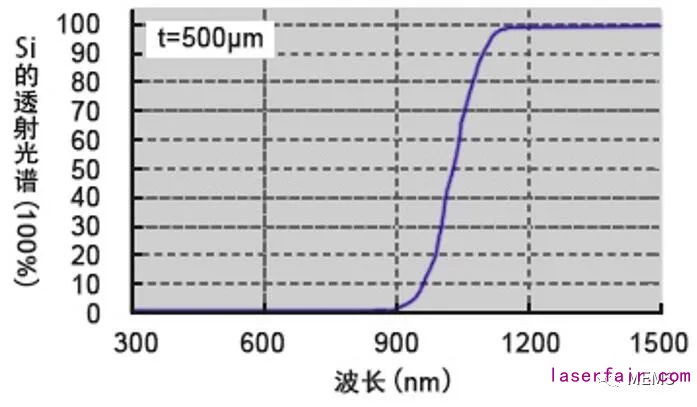
图2 硅材料透射光谱的特性
硅材料透射光谱的特性,见图2,硅材料对红外透过率很高,所以硅的隐形切割设备,通过选用短脉冲红外激光器,将激光脉冲聚焦到硅衬底内部,实现隐形切割。激光隐形切割是非接触式切割,解决了砂轮切割引入外力冲击对产品破坏的问题。不过一般设备的激光隐形切割形成的改质层区域会使材料变得酥脆,还是会形成少量细小硅碎屑掉落,虽然碎屑数量远少于砂轮切割,如前文所述,MEMS晶圆因为无法通过清洗的方法去除细小硅碎屑,故这些碎屑将对芯片造成破坏,影响良率。德龙激光生产的硅晶圆激光切割设备,见图3,选用自制的红外激光器和自主开发的激光加工系统,实现硅晶圆的隐形切割,该设备能够很好的控制隐形切割后碎屑的产生,从而满足高品质MEMS晶圆切割的要求,保证切割良率。德龙激光的硅晶圆激光切割设备自推向市场后,得到了国内多家量产客户的认可和好评,设备在多个MEMS制造厂内批量切割诸如硅麦克风/电热堆/陀螺仪等MEMS产品。实物切割效果图见图4。

图3 德龙硅晶圆激光切割设备外观图

图4 MEMS产品切割效果图
来源:MEMS公众号MEMS(Micro-Electro-Mechanical System)即微电子机械系统,一般由微机械结构、微传感器、微执行器和控制电路组成,MEMS是通过半导体工艺实现不同能量形式之间的转换的一种芯片。根据能量转换形式的不同,一般分为传感器和执行器两类,传感器即感测到外界信号并将其转换成所需的信号(一般是电信号)进行处理,应用有:惯性传感器、硅麦克风等;执行器即将控制信号(一般是电信号)转化为其他形式的能量(一般是机械能)输出,应用有:光学系统、RF MEMS等。
MEMS的制造主要采用Si材料,它与IC的不同在于,IC是电信号的传输、转换及处理,而MEMS是电信号和其他形式能量间的转换(以机械能为典型),所以在MEMS制造中往往需要利用半导体工艺在Si上制作悬梁、薄膜、空腔、密封洞、针尖、微弹簧等复杂的机械结构,这些微机械结构容易因机械接触而损坏、因暴露而沾污,能承受的机械强度远远小于IC芯片。基于这样的特点,MEMS晶圆的划片方法不同于典型IC的划片。典型IC砂轮划片是通过砂轮刀片高速旋转来完成材料的去除,从而实现芯片切割。由于刀片的高速旋转,往往需要使用纯水进行冷却和冲洗,那么刀片高速旋转产生的压力和扭力,纯水的冲洗产生的冲击力以及切割下来的Si屑造成的污染都容易对MEMS芯片中机械微结构造成不可逆的破坏。所以典型IC的砂轮划片不适用MEMS晶圆的划片。
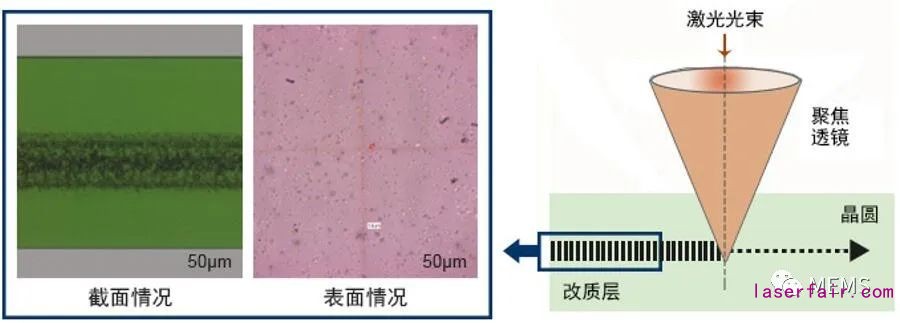
图1 激光隐形切割在玻璃中的应用切割示意图
激光隐形切割作为激光切割晶圆的一种方案,很好的避免了砂轮划片存在的问题。如图1所示,激光隐形切割是通过将脉冲激光的单个脉冲通过光学整形,让其透过材料表面在材料内部聚焦,在焦点区域能量密度较高,形成多光子吸收非线性吸收效应,使得材料改性形成裂纹。每一个激光脉冲等距作用,形成等距的损伤即可在材料内部形成一个改质层。在改质层位置材料的分子键被破坏,材料的连接变的脆弱而易于分开。切割完成后通过拉伸承载膜的方式,将产品充分分开,并使得芯片与芯片之间产生间隙。这样的加工方式避免了机械的直接接触和纯水的冲洗造成的破坏。目前激光隐形切割技术可应用于蓝宝石/玻璃/硅以及多种化合物半导体晶圆。
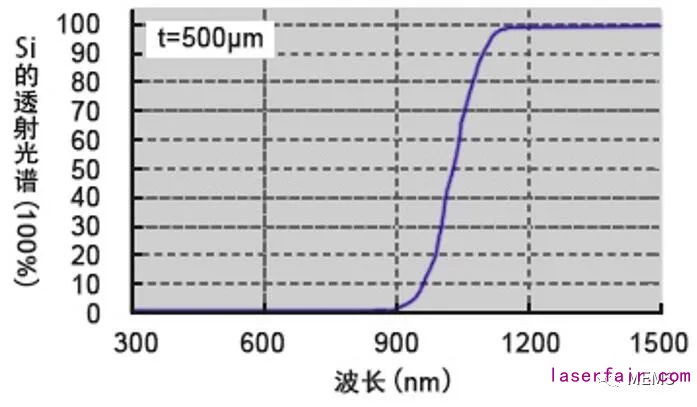
图2 硅材料透射光谱的特性
硅材料透射光谱的特性,见图2,硅材料对红外透过率很高,所以硅的隐形切割设备,通过选用短脉冲红外激光器,将激光脉冲聚焦到硅衬底内部,实现隐形切割。激光隐形切割是非接触式切割,解决了砂轮切割引入外力冲击对产品破坏的问题。不过一般设备的激光隐形切割形成的改质层区域会使材料变得酥脆,还是会形成少量细小硅碎屑掉落,虽然碎屑数量远少于砂轮切割,如前文所述,MEMS晶圆因为无法通过清洗的方法去除细小硅碎屑,故这些碎屑将对芯片造成破坏,影响良率。德龙激光生产的硅晶圆激光切割设备,见图3,选用自制的红外激光器和自主开发的激光加工系统,实现硅晶圆的隐形切割,该设备能够很好的控制隐形切割后碎屑的产生,从而满足高品质MEMS晶圆切割的要求,保证切割良率。德龙激光的硅晶圆激光切割设备自推向市场后,得到了国内多家量产客户的认可和好评,设备在多个MEMS制造厂内批量切割诸如硅麦克风/电热堆/陀螺仪等MEMS产品。实物切割效果图见图4。

图3 德龙硅晶圆激光切割设备外观图

图4 MEMS产品切割效果图
来源:MEMS公众号MEMS(Micro-Electro-Mechanical System)即微电子机械系统,一般由微机械结构、微传感器、微执行器和控制电路组成,MEMS是通过半导体工艺实现不同能量形式之间的转换的一种芯片。根据能量转换形式的不同,一般分为传感器和执行器两类,传感器即感测到外界信号并将其转换成所需的信号(一般是电信号)进行处理,应用有:惯性传感器、硅麦克风等;执行器即将控制信号(一般是电信号)转化为其他形式的能量(一般是机械能)输出,应用有:光学系统、RF MEMS等。
MEMS的制造主要采用Si材料,它与IC的不同在于,IC是电信号的传输、转换及处理,而MEMS是电信号和其他形式能量间的转换(以机械能为典型),所以在MEMS制造中往往需要利用半导体工艺在Si上制作悬梁、薄膜、空腔、密封洞、针尖、微弹簧等复杂的机械结构,这些微机械结构容易因机械接触而损坏、因暴露而沾污,能承受的机械强度远远小于IC芯片。基于这样的特点,MEMS晶圆的划片方法不同于典型IC的划片。典型IC砂轮划片是通过砂轮刀片高速旋转来完成材料的去除,从而实现芯片切割。由于刀片的高速旋转,往往需要使用纯水进行冷却和冲洗,那么刀片高速旋转产生的压力和扭力,纯水的冲洗产生的冲击力以及切割下来的Si屑造成的污染都容易对MEMS芯片中机械微结构造成不可逆的破坏。所以典型IC的砂轮划片不适用MEMS晶圆的划片。
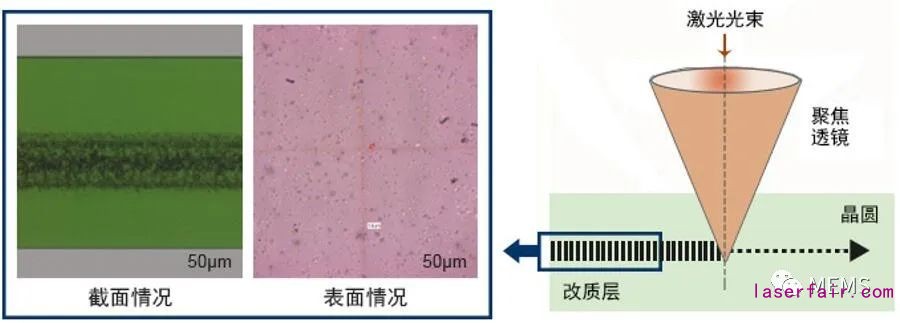
图1 激光隐形切割在玻璃中的应用切割示意图
激光隐形切割作为激光切割晶圆的一种方案,很好的避免了砂轮划片存在的问题。如图1所示,激光隐形切割是通过将脉冲激光的单个脉冲通过光学整形,让其透过材料表面在材料内部聚焦,在焦点区域能量密度较高,形成多光子吸收非线性吸收效应,使得材料改性形成裂纹。每一个激光脉冲等距作用,形成等距的损伤即可在材料内部形成一个改质层。在改质层位置材料的分子键被破坏,材料的连接变的脆弱而易于分开。切割完成后通过拉伸承载膜的方式,将产品充分分开,并使得芯片与芯片之间产生间隙。这样的加工方式避免了机械的直接接触和纯水的冲洗造成的破坏。目前激光隐形切割技术可应用于蓝宝石/玻璃/硅以及多种化合物半导体晶圆。
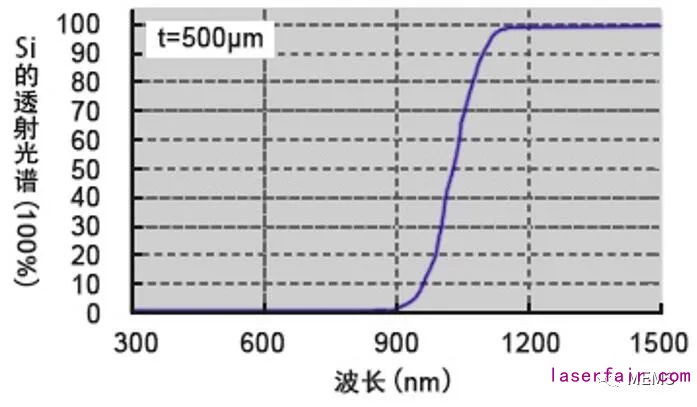
图2 硅材料透射光谱的特性
硅材料透射光谱的特性,见图2,硅材料对红外透过率很高,所以硅的隐形切割设备,通过选用短脉冲红外激光器,将激光脉冲聚焦到硅衬底内部,实现隐形切割。激光隐形切割是非接触式切割,解决了砂轮切割引入外力冲击对产品破坏的问题。不过一般设备的激光隐形切割形成的改质层区域会使材料变得酥脆,还是会形成少量细小硅碎屑掉落,虽然碎屑数量远少于砂轮切割,如前文所述,MEMS晶圆因为无法通过清洗的方法去除细小硅碎屑,故这些碎屑将对芯片造成破坏,影响良率。德龙激光生产的硅晶圆激光切割设备,见图3,选用自制的红外激光器和自主开发的激光加工系统,实现硅晶圆的隐形切割,该设备能够很好的控制隐形切割后碎屑的产生,从而满足高品质MEMS晶圆切割的要求,保证切割良率。德龙激光的硅晶圆激光切割设备自推向市场后,得到了国内多家量产客户的认可和好评,设备在多个MEMS制造厂内批量切割诸如硅麦克风/电热堆/陀螺仪等MEMS产品。实物切割效果图见图4。

图3 德龙硅晶圆激光切割设备外观图

图4 MEMS产品切割效果图
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读





















 关注我们
关注我们




