单刀直入,能赚钱的激光设备工艺有如下:
1)激光晶圆退火
2)激光解键合
3)激光晶圆开槽
4)激光晶圆切割
5)激光晶圆飞抛
6)激光MEMS切割
7)激光晶圆切割道边打标
8)激光切割IC载板
9)激光晶圆正面打标
10)激光芯片背面打标
11)激光固化材料
12)激光TSV钻孔与IC载板钻孔
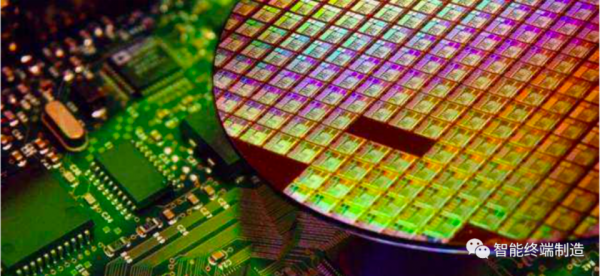
目前,中国的半导体市场需求约占全球市场需求的三成。然而,在产能方面,中国大陆厂商仅掌握全球不到1%的12英寸晶圆产能,位于中国大陆(包括外商独资)的12英寸晶圆产能则有8%。巨大的半导体市场潜力与制程技术的局限性并存,使得中国大陆成为投资半导体制造的热点。
中国半导体产业发展迅速,半导体产业逐渐呈现向大陆地区转移的新趋势,为中国各行业的发展带来了设备国产化的机遇。此外,政府政策大力支持半导体产业发展,大量资金将加速产业转型升级和成熟发展。
目前,中国是世界上最大的集成电路市场,需求量巨大。近年中国通信基础设施的建设、智能终端持续发酵,以及汽车智能、5G、物联网、车联网、智慧城市的建设等,为中国IC产业持续注入动力。加之,中国政府的积极引导进一步推动了半导体制造业的发展。可以预见,中国半导体产业将进入黄金时代,而这一切的背后都需要有强而有力的晶圆代工来支持。多年来,与欧美、日韩和台湾省相比,中国芯片行业一直处于弱势地位。近年来,中国在半导体行业的R&D投资逐渐增加,芯片市场占GDP的比重持续上升。
随着激光技术的不断发展以及激光技术深入半导体行业,激光已经在半导体领域多道工序取得成功应用。广为熟知的激光打标,使得精细的半导体芯片标识不 再是个难题。激光切割半导体晶圆,一改传统接触式刀轮切割弊端,解决了诸如刀轮切割易崩边、切割慢、易破坏表面结构等诸多问题。在集成电路工艺线宽越来越 小的情况下,LOW-K材料(K为介电常数,即低介电常数材料)越来越多的应用于集成IC中,由于LOW-K层传统工艺很难加工,于是引入了激光开槽工 艺,利用激光将切割道中LOW-K层去除。目前12寸硅晶圆已广泛应用于半导体集成电路领域,而且晶圆越做越薄,将薄晶圆键合于承载晶圆片上流片后通过拆 键和将两部分分开,激光拆键以其高效率无耗材等诸多优势成为关注热点。另外激光还在钻孔、划线、退火等工序取得不错的应用成果。
激光设备的优势细化描述如下,列举几个工艺细节!
近年来制造产业的快速发展,高集成度和高性能的半导体晶圆需求不断增长,硅、碳化硅、蓝宝石、玻璃以及磷化铟等材料作为衬底材料被广泛应用于半导体 晶圆领域。随着晶圆集成度大幅提高,晶圆趋向于轻薄化,传统的很多加工方式已经不再适用,于是在部分工序引入了激光技术。激光加工具有诸多独特的优势:

A. 非接触式加工:激光的加工只有激光光束与加工件发生接触,没有刀削力作用于切割件,避免对加工材料表面造成损伤。
B. 加工精度高:脉冲激光可以做到瞬时功率极高、能量密度极高而平均功率很低,可瞬间完成加工且热影响区域极小,确保高精密加工。
C. 加工效率高,经济效益好:激光加工效率往往是机械加工效果的数倍且无耗材无污染。
1 激光隐形切割
激光隐形切割是一种全新的激光切割工艺,具有切割速度快、切割不产生粉尘、无切割基材耗损、所需切割道很小、完全干制程等诸多优势。其原理是将短脉 冲激光光束透过切割材料表面聚焦在材料中间,由于短脉冲激光瞬时能量极高,在材料中间形成改质层,然后通过外部施加压力使芯片分开。中间形成的改质层如图 1所示:

图1 300μm厚晶圆截面图
目前激光隐形切割技术广泛应用于LED芯片、MEMS芯片、FRID芯片、SIM芯片、存储芯片等诸多晶圆的切割,如图2以硅衬底MEMS晶圆为例,可以看到隐形切割的芯片几乎没有崩边和机械损伤。
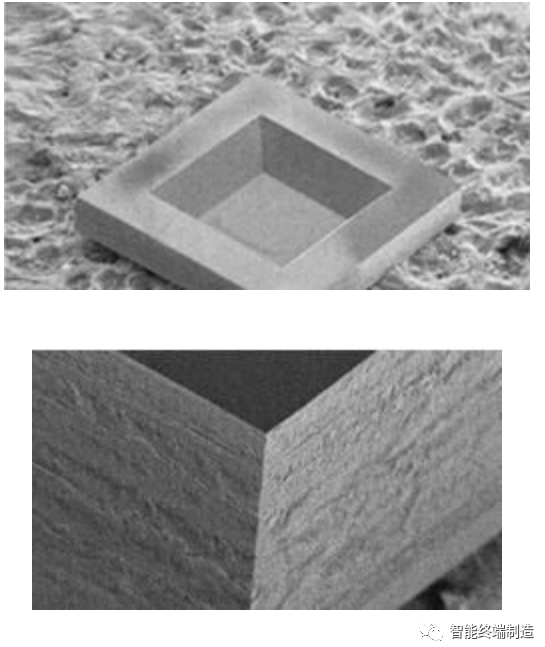
图2 MEMS晶圆激光切割效果图
隐形切割也有它的局限性,由于隐形切割需要将特定波长的激光聚焦于物质的内部,所切割的物质必须对特定波长的激光具有较大的透射率,另外需要切割道内光滑以防止对照射的激光形成漫反射。目前隐形切割能够切割Si、SiC、GaAS、LiTaO3、蓝宝石、玻璃等材料。
2 激光表面烧蚀切割
表面烧蚀切割是较为普遍的激光切割工艺,其原理是将激光聚焦于所需材料的表面,聚焦的地方吸收激光能量后形成去除性的融化和蒸发,在切割表面形成一定深度的"V"型口,然后通过外部施加压力使芯片分开。切割完后的"V"型槽如图3所示:
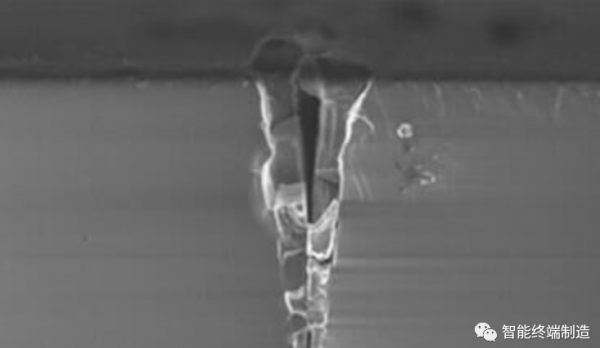
图3 激光表面切割形成的"V"型口
激光表面切割具有更强的通用性,使用超短脉冲激光进行表面切割能够很好的将热影响区域控制在很小的范围内。目前该激光切割技术广泛应用于GPP工艺的晶圆、四元LED晶圆等晶圆的切割中。如图4以四元LED芯片为例,我们可以看到激光表面切割能够有较好的切割面。
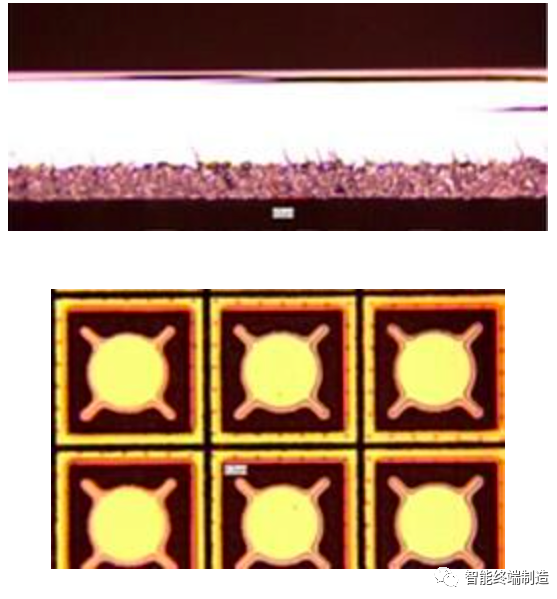
图4 激光表面切割截面以及切割效果图
对比隐形切割技术,激光表面切割的工艺窗口更宽,但是它也有不足之处:
A. 切割效率往往低于隐形切割;
B. 部分晶圆切割前需要涂覆保护液,切割完后需要清洗保护液;
C. 晶圆越厚需要切割越深,表面的开口就越大,热影响区也就越大。
针对激光解键合中,有微波等离子需求。那个厂家要这类设备,可以咨询13510701028,已经大厂案例,且价格实惠,服务到位!
国内还有几个重要晶圆激光工艺有待提高是哪些?
第一个是TSV钻孔,第二个是晶圆飞抛。这两个工艺基本被日本企业垄断,国内要想快速在晶圆激光加工领域获利,搞这两个工艺就以了。
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读





















 关注我们
关注我们




