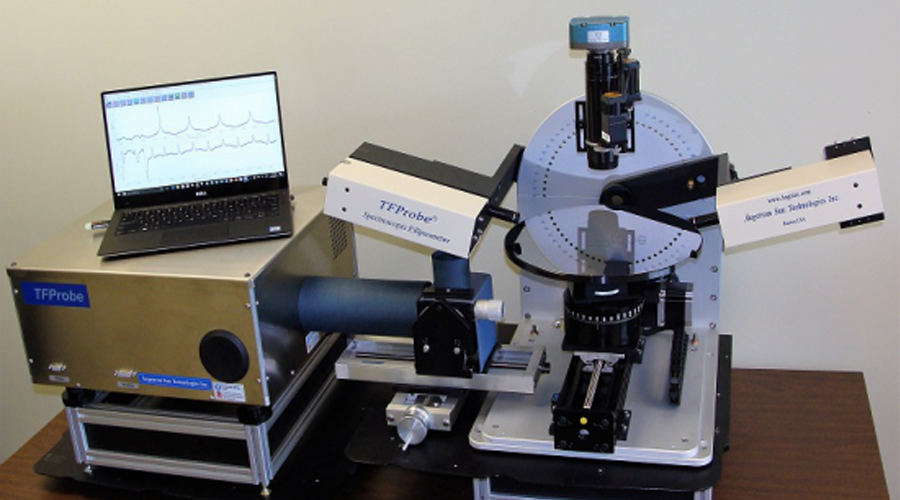
红外光谱椭偏仪
一、在半导体工艺中,掺杂杂质类型、浓度及结深的改变都会引起不同频率的红外光谱,介绍了一种通过红外椭偏仪测量浅结杂质分布的方法:利用 Drude 方程将 Si 中不同掺杂与其引起的光学常量的变化对应起来,通过红外椭偏分量 Ψ 和 Δ 的测量及模型拟合来测定半导体中载流子的浓度分布。并建立高斯渐变层模型,即将离子注入退火后的非均匀掺杂层分成 n 小层,各层载流子浓度之间符合高斯分布,且每一层载流子浓度可以用 Drude 方程来描述。测量采用了可变角度的红外光谱椭偏仪,该测量方法具有非接触性、非破坏性的优点,测量快捷方便。
本文介绍一种利用红外椭偏光谱仪测量半导体中载流子浓度的方法。利用红外椭偏仪测量 Si 中离子注入退火后的杂质浓度分布,具有测量精度高﹑非损伤性以及能区分不同物理效应等优点。掺杂半导体的光学吸收系数和折射率与其中自由电子或空穴浓度有关。从原理上说,可以借助测量吸收系数或反射率来确定半导体中载流子浓度。同时半导体杂质注入退火后的载流子分布近似服从高斯分布,红外椭偏仪正是基于以上两点完成测量、模型建立及数据拟合,从而确定杂质浓度分布的。利用这种光学方法的优点在于非接触和非破坏性的,适用于浅结杂质分布的测量。
红外椭偏仪的测量原理与普通的光谱椭偏仪一样,也是测量椭偏参量 ψ 和 Δ。不同的是普通椭偏仪的光谱范围为 0. 37 ~ 1 μm,通常用来测量介质层、聚合物等薄膜厚度及光学常数。红外椭偏仪的光谱范围为 2 ~ 30 μm,在这一光谱范围内,半导体的光学吸收系数和折射率与其中自由电子或空穴浓度有关。可以借助于测量吸收系数或反射率来确定半导体中载流子浓度。
二、模型的建立
注入退火后载流子分布与 SiO2 和 SiN 等固定介电常数介质膜不同。注入退火后载流子分布是非均匀分布,其介电常数随结深的不同而变化,因此可以建立一个渐变层模型,即将整个掺杂层分为 n层,n 取值足够大时,即可假定在每一小层内有固定的介电常数。每一层的光学特性可以用经典Drude 模型来描述,该模型是将半导体的电特性和光学特性相对应的一种模型。本次测量建立了两个模型: ①在 n 型衬底注入p 型杂质并退火的模型; ②在 p 型称底注入 n 型杂质并退火的模型。椭偏测量模型先通过 Drude 模型定义各层掺杂浓度,再通过高斯分布将测得的各层杂质原子分数联系起来得到一个连贯的浓度分布图。

三、结论
通过红外光谱椭偏仪对掺杂半导体进行椭偏数据测量,又通过 Drude 渐变层模型对测量数据进行拟合,从而得到载流子的杂质分布图。从杂质分布图可以得到峰值浓度杂质的、结深等掺杂层信息。
红外椭偏测量具有非接触性、非破坏性的优点,测量快捷方便,可作为半导体制造工艺中在线监控杂质分布、结深的有效手段。尤其能够对浅结杂质分布进行测量。缺点是掺杂浓度低时,通常是低于 10 18 cm-3 ,杂质在红外波段引起的折射率及介电常数变化不灵敏,因此测量精确度不太高。
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读





















 关注我们
关注我们




