
式中D 为曝光剂量;T 为曝光时间;I 为曝光光强, 是时间t 的函数。曝光剂量直接影响光刻机的性能指标, 如关键尺寸(Critical dimension , CD)、关键尺寸均匀性、生产效率等, 必须加以严格控制, 才能实现最佳的曝光均匀性和稳定性 。
目前光刻技术已从步进曝光方式发展为扫描曝光方式, 普遍采用波长248 nm 和193 nm 的深紫外准分子激光 。由于预热、气体退化或更新、以及运行时间等因素影响, 准分子激光器总会存在单脉冲能量波动和平均脉冲能量漂移, 除此之外还有能量超调(o vershot)现象。能量超调是指一组脉冲与一组脉冲之间气体处于不放电状态, 导致每一组脉冲的前若干个脉冲在相同的高电压下输出能量值要高很多, 超调幅度可达20 % 。扫描曝光时, 曝光场内各点匀速经过曝光狭缝, 从而接收到一定数量的脉冲, 其累积值就是该点处的曝光剂量 。显然,脉冲能量波动特别是超调现象直接影响最终的曝光剂量, 多个脉冲则能起到平滑效应, 且理论上脉冲个数越大效果越好;但在实际光刻应用中, 单纯增加脉冲个数往往通过调整衰减片角度来实现, 其结果是降低光刻生产率且增加激光器能耗。
单脉冲能量波动和超调现象是准分子激光器的固有特性, 通过改善激光器本身性能特别是从光学上改善其性能尚不足以消除这种现象及其不利影响, 必须采用算法控制进行补偿 。为此, 本文提出一种实时剂量控制算法, 采用闭环反馈控制方式对激光器发出的每个脉冲进行严格控制, 以抑制单脉冲能量的随机波动特别是超调现象;同时尽可能采用少的脉冲个数, 以保证在满足剂量精度要求的情况下, 尽可能提高光刻生产率和激光器使用效率。
2、实时剂量控制算法
2. 1光刻机扫描曝光模型
扫描曝光过程的抽象模型如图1 所示。激光器发出的脉冲光束经过光路传输系统, 从开口大小可调的狭缝中投影到工件台上, 形成投影光斑。当曝光场前沿与光斑前沿重合时, 扫描开始;此后曝光场匀速经过投影光斑;当曝光场后沿与光斑后沿重合时, 扫描结束。
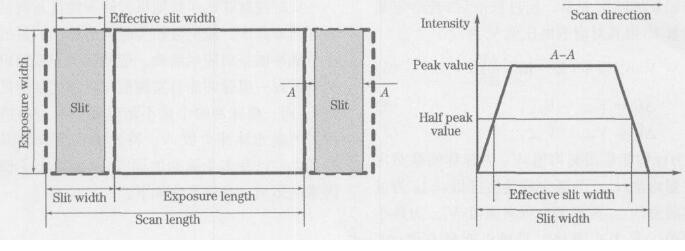
在扫描曝光过程中, 激光器的重复频率f 固定,狭缝等效宽度L 为定值, 工件台以匀速v 经过扫描狭缝, 则曝光场中每个点经过狭缝时都接收到相同数量的脉冲, 其个数N 为


2.2光刻机剂量控制器结构
扫描投影光刻机剂量控制系统如图2 所示, 从准分子激光器发出的脉冲激光, 先经过底端照明光路(包括光束扩充镜组、定位定向镜组、缩放锥形镜组等)和可变透过率衰减片, 到达能量传感器, 再经过顶端照明光路(包括光能量均匀棒、扫描狭缝、照明镜组等)、掩模版和投影物镜, 最终投射到硅片表面。光路中安装有一个能量传感器, 测量每个激光脉冲的能量并结合实时调节算法, 计算出下一个单脉冲能量的设定值;最后通过能量电压转换关系将能量设定值转换成电压设定值, 以达到控制激光器单脉冲能量并保证剂量精度的目的。

剂量控制器的结构如图2 中虚框所示, 其中, 能量电压转换关系是通过校准和标定流程来获得的。激光器一般有三个指标:最小、最大和标称能量, 校准时使激光器分别以这三个量值发出一定数量的脉冲, 统计所加电压, 近似认为在这个范围内电压与能量为线性关系, 通过在两极值点间线性插值, 得到一组电压与能量的匹配关系。经过校准后, 若给定某个脉冲能量E , 则其对应的电压值V 为

2.3激光器单脉冲能量实时控制算法
实时控制算法包括随机波动和能量超调两部分实时调节算法。随机波动实时调节算法的目的是减小单脉冲能量的随机波动。待发脉冲能量的设定值偏差源自一组脉冲能量实测值与标称能量值的偏差累积, 而一组脉冲的个数不超过各点经过扫描狭缝所需的激光脉冲个数N 。待发的每个脉冲因此都受到之前已发多个脉冲的调节, 从而减小了偶然性因素的影响。具体算法如下:

式中ΔEs(i)为考虑随机波动的第i 个脉冲的能量设定值偏差;ks 为随机波动控制调节系数;ε为实测能量等效为激光器输出能量的系数;Em(f )为第f 个脉冲的实测能量;N 为硅片上每个点经过扫描狭缝所需的激光脉冲个数。
超调算法的目的是抑制脉冲能量超调现象。超调相对而言是一种局部行为, 其调节可以采用加权移动平均。具体算法如下:

式中δEs(i)为考虑超调的第i 个脉冲能量设定值偏差;k o 为超调控制调节系数;Es(g)为第g 个脉冲的能量设定值;M 为超调移动平均个数, 一般取值为5 。综合两部分算法, 可以得到准分子激光器单脉冲能量实时调节的综合控制算法:

3、实验研究与结果分析
为研究准分子激光器的单脉冲能量特性并验证上述控制算法, 在一台ArF 准分子激光器上进行了相关实验, 其波长为193 nm , 标称脉冲能量5 mJ , 最大重复频率4 kHz , 功率20 W 。该ArF 准分子激光器上实测的脉冲能量变化曲线如图3 所示。工作模式为恒电压控制方式, 高电压(HV)设定值恒定为1690 V , 重复频率为4 kHz 。图3(a)显示了光刻机步进扫描曝光过程的数据, 每个硅片有70 个曝光场(图中显示了其中的20 个), 每个曝光场的脉冲总数为375 , 曝光场之间的时间间隔为100 ms(图中以符号" +"表示曝光场间隔), 即每个曝光场的扫描时间为93. 75 ms , 步进时间为100 ms 。图3(b)显示了单个曝光场的脉冲能量变化细节。


对多种剂量需求值下的恒电压控制方式进行了多个曝光场的步进扫描曝光实验, 所得统计分析结果如表1 所示, 其中Dmax 为最大剂量,Dmin 为最小剂量, σ为剂量精度。从中可以看出, 尽管脉冲累积对随机波动确实起到了很好的平滑效应, 但脉冲个数增大到一定程度后, 这种平滑效果趋于平缓。更为重要的是, 由于能量超调现象的存在, 恒电压控制方式下的剂量精度非常差, 即使在脉冲个数为100 时剂量精度也仅为11. 9 %, 根本不能满足亚微米光刻的要求, 因而有必要采用高性能的实时算法进行剂量控制。
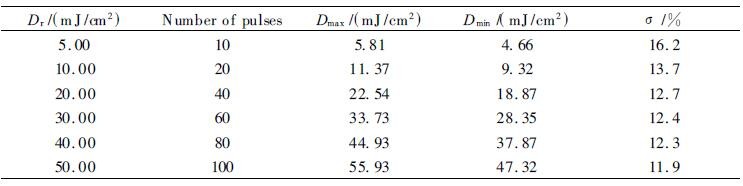
采用本文提出的实时剂量控制算法获得的脉冲能量变化曲线如图5 所示, 即利用本文提出的控制算法进行激光器外部单脉冲高电压控制, 其余实验参量与图3 相同。图5(a)显示了光刻机步进扫描曝光过程的数据, 图5(b)显示了单个曝光场的脉冲能量变化细节。剂量控制算法的相关参量为N =20 , M =5 , ks =0. 8 , ko =0. 8 。
从图5 中可以明显看出, 采用本文提出的外部高电压实时剂量控制算法, 不仅明显减小了单脉冲能量的随机波动, 而且有效抑制了能量超调现象。这在观察多个脉冲能量的累积和即观察曝光剂量时更为显著, 如图6 所示, 图6(a)~ 图6(f)对应狭缝脉冲个数分别为10 , 20 , 40 , 60 , 80 和100 , 剂量需求值分别为5 mJ/cm2 , 10 mJ /cm2 , 20 mJ/cm2 , 30 mJ /cm2 ,40 mJ /cm2 和50 mJ /cm2 。


多种剂量需求值时外部高电压实时控制方式下的剂量测试统计分析结果如表2 所示。从中可以看出, 采用本文提出的外部高电压实时控制算法, 曝光剂量可以达到相当高的精度, 在脉冲个数N 为20时剂量精度可达0. 89 %, N 大于20 时均完全满足亚微米光刻的苛刻要求, 且N 越大, 精度越高。
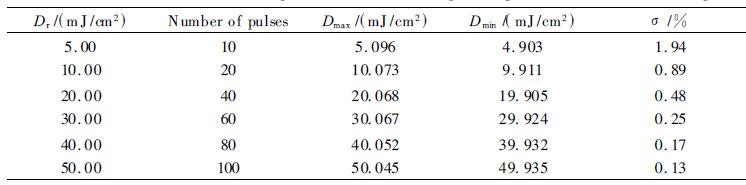
4、结论
提出了一种面向步进扫描投影光刻机的深紫外准分子激光实时曝光剂量控制算法, 并在一台A rF准分子激光器上开展了相关实验。研究结论如下:
1) 准分子激光器的单脉冲能量呈现非常明显的波动现象, 波动幅度可达20 %以上, 这种波动现象主要体现在两个方面:一是能量超调, 二是随机波动。
2) 曝光剂量是多个脉冲能量的累积, 尽管累积对随机波动起到了很好的平滑效应, 但由于超调的存在, 恒电压控制方式下的剂量精度非常差, 无法满足亚微米光刻苛刻的剂量要求。
3) 提出的外部高电压实时控制算法, 明显减小了单脉冲能量的随机波动, 而且有效抑制了能量超调现象, 在脉冲个数较小的情况下即可获得很高的剂量精度。
转载请注明出处。








 相关文章
相关文章
 热门资讯
热门资讯
 精彩导读
精彩导读





















 关注我们
关注我们




